衷于從縮小晶體管來提高密度和性能。在相同的成本上具有更快的速度、更大的內存,是一件多么美妙的事情!越來越多的在工藝上的進步目前已能使完好的特征尺寸升級到90nm技術節點。然而,在深層納米尺寸滿足對漏電和性能的需要卻迅速地把傳統的晶體管逼入困境。
要使性能得到繼續的升級,人們正在采用新型材料和結構來改善傳統的CMOS工藝。在超過32nm及以上的技術上,面對著功率性能前所未有的挑戰,晶體管可能通過一系列的跳躍式創新得到發展嗎?盡管答案仍在探索之中,從金屬/高K柵堆疊、新型應變硅到多柵器件等等新型材料和器件結構競相發起這場革命。
當晶體管忙于開關時,微小的晶體管會消耗能量,因此依靠封裝更多的晶體管來提高密度并不湊效。不同工藝的能耗可通過動態功率來測得:
動態功率=CVdd2F
C=器件電容
Vdd=電源電壓
F=開關頻率
此外,作為一種并不完全的開關,即使當它們關閉時也會漏電,這一點對待機功耗起到作用。
待機功耗=I漏電xVdd
I漏電=漏電電流
當你把10億只晶體管集成到一個100mm2面積的裸片上時,功耗就會迅速增加,且情況正變得更糟。對功耗進行管理是當前從系統、設計到工藝的所有人員的壓倒一切的活動。降低功耗并不難,難在你要跟性能進行平衡。
短溝道靜電學
由于工藝和材料的限制,在我們急于壓縮門柵和溝道尺寸之時,源/漏結點和門柵電介質的升級卻不沒能跟上不能步伐。這導致短溝道靜電更加不足,當器件關閉 時,門柵對源-漏的漏電影響更弱(也就是亞門限模式)。隨著在門柵與超出正常界線的源/漏之間的溝道電荷分配的增加(如圖1),會導致亞門限漏電增加,這 點可從門限電壓出乎我們意料的降低中反映出來(圖2)。
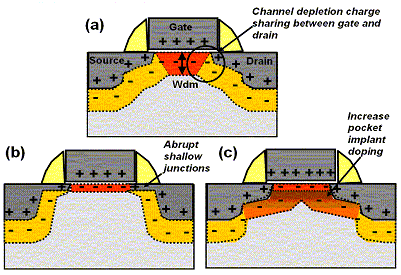
圖1:器件電荷分配的影響有以下三種情況:(a)統一的溝道滲雜;(b)超淺結;(c)高的容器植入摻雜。
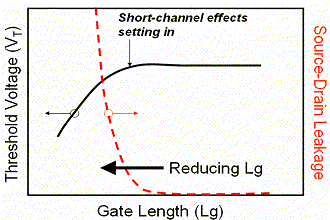
圖2:以門柵極長度(Lg)為函數的器件閥值電壓(VT)及源/漏漏電的曲線。對于更小的Lg,短溝道效應的開始造成VT減少。這一點同時伴隨著源?漏漏電的指數增長。
要緩減這一狀況,我們可使源和漏結點(xj)更淺且更陡(圖1b),或者通過增加結點周圍的溝道摻雜,來屏蔽靜電對源/漏的影響(降低耗盡寬度) (1c)。由于低阻抗超淺結點特別具有挑戰性,我們在進行伸縮時,大量的增加溝道摻雜來抑制漏電。增加摻雜會帶來兩種不良的副作用,會導致開關電流 (Ion/Ioff)比急劇降低,該比值對于好的開關應被最大化。通過實現低亞門限擺幅(S),靜電的開關比可(圖3)以最大化。一個簡單的一維MOS電 容器的S描述忽略了由[1]給出的源/漏的電荷分配的影響:
S = 1/(亞門限斜率) = 2.3 kT/q (1 + Cdm/Cox) ~ 2.3 kTq (1 + 3Tox/Wdm)
T = 溫度
Cdm = 損耗電容
Cox =門柵電容
Tox =門柵電介質厚度。
Wdm = 溝道損耗寬度
取決于柵極與溝道之間的電容耦合(Cdm/Cox),S測量門 柵在關閉與打開溝道之間擺動的良好程度。增加溝道摻雜,而不使門柵電介質厚度(Tox)相應地減少,會導致S的增加。對于短溝道MOSFET,S也可通過 門柵與短溝道之間的電荷分配得到增加,這也會受到終接電壓的影響。顯然,在維持良好短溝道控制時,如果缺乏溝道摻雜(Cdm~0),S值就最小(例如,最 小化的源/漏門柵電荷分配)。如果不能完全自由地伸縮門柵電介質厚度及結點深度,由于短溝道控制在那時變得極度依賴于越來越多的溝道摻雜,從而使S最小化 對于體MOSFET而言就是一個令人畏懼的事情。
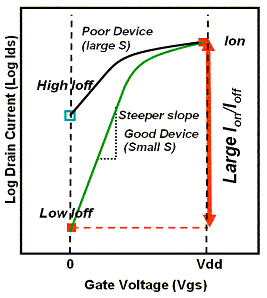
圖3:具有匹配的電流,但具有不同的亞門限斜率的兩個器件之間的亞門限行為。
摻雜的另一個高代價是損傷傳輸速度。具有高溝道摻雜的器件被迫在更高門柵電場進行工作。這增加了具有門柵電介質界面溝道載流子的散射,導致載流遷移率(圖4)和折衷的驅動性能的大幅下降。
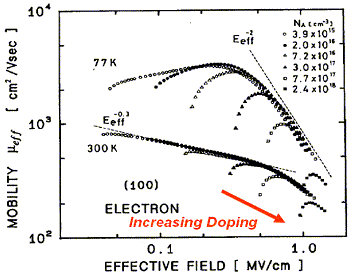
圖4:對于不同溝道摻雜水平(NA)和溫度[2], MOSFET的電子遷移率是有效電場的函數。
。 (本文來源網絡整理,目的是傳播有用的信息和知識,如有侵權,可聯系管理員刪除)
版權聲明:網站轉載的所有的文章、圖片、音頻視頻文件等資料的版權歸版權所有人所有。如果本網所選內容的文章作者及編輯認為其作品不宜公開自由傳播,或不應無償使用,請及時聯絡我們,采取適當措施,避免給雙方造成不必要的經濟損失。